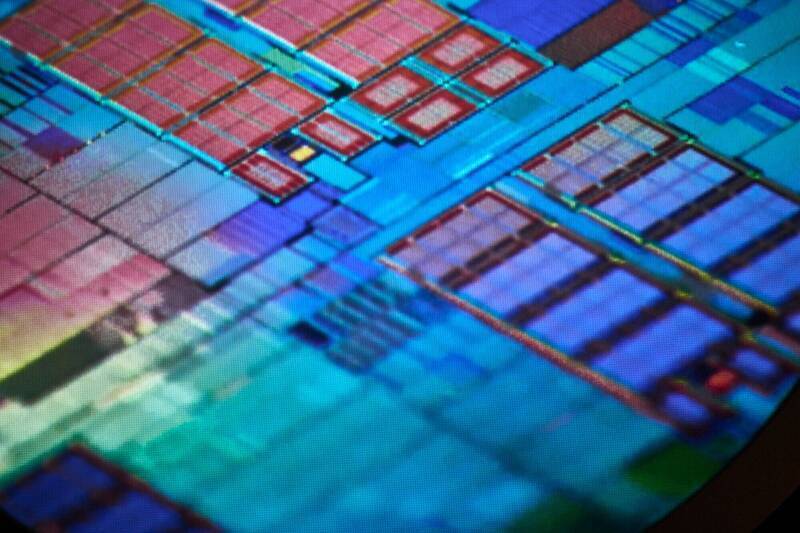 小摩表示,CoWoP具有簡化系統結構,更好的熱管理性能和更低功耗等優勢,但受制於多重技術挑戰,中期內商業化機率低。(示意圖,彭博)
小摩表示,CoWoP具有簡化系統結構,更好的熱管理性能和更低功耗等優勢,但受制於多重技術挑戰,中期內商業化機率低。(示意圖,彭博)
高佳菁/核稿編輯
〔財經頻道/綜合報導〕輝達正在探索一項革命性的晶片封裝技術CoWoP(Chip-on-Wafer-on-PCB),取代CoWoS封裝方案,小摩指出,CoWoP將利用先進的高密度PCB(印刷電路板)技術,去除CoWoS封裝中的ABF載板,直接將中介層與PCB連接,具有簡化系統結構,更好的熱管理性能和更低功耗等優勢,小摩認為,受制於多重技術挑戰,中期內商業化機率低,然一旦技術成功,則ABF載板將成為最大受害者,而PCB將迎來重大機會。
外媒報導,摩根大通報告指出,CoWoP代表Chip-on-Wafer-on-PCB技術路徑。在完成晶片-晶圓中介層製造步驟後,中介層直接安裝到PCB上,而不是像CoWoS製程那樣綁定到ABF載板上。
CoWoP技術的潛在優勢包括:簡化系統結構,透過減少傳輸損耗,提高資料傳輸效率,確保NVLink互連更高的範圍;更好的熱管理性能和更低的功耗;降低每代產品都在上升的載板成本;潛在減少一些後端測試步驟。
然而,摩根大通認為,這項技術存在關鍵挑戰。目前只有蘋果採用mSAP或SLP PCB技術,但其節距尺寸更大,PCB板面積更小,因此將此技術擴展到具有更高載流能力的大型GPU仍然是技術和營運挑戰。
摩根大通報告中稱,對ABF載板廠商而言,這顯然是負面消息,因為載板附加值可能會大幅減少或完全消失,更複雜、精細節距的信號路由將轉移到RDL層(中介層),而高端PCB層承擔封裝內路由步驟。
摩根大通認為,對於PCB製造商,是一個重大機會高速。報告指出,性能與主機板高電流/電壓要求之間的權衡是阻止平台PCB實現真正基板規格的主要挑戰。mSAP是在實現25/25微米更精細線/間距尺寸方面最佳的PCB技術,但仍遠低於ABF的亞10微米線/間距能力。
因此,小摩認為,具備先進mSAP能力,以及基板/封裝製程深度知識的公司將更有優勢。
雖然,摩根大通分析師認為,由於多重技術挑戰,CoWoP中期內商業化的機率仍然較低,不過,無論CoWoP是否成功量產,輝達都透過系統級方法繼續引領資料中心AI基礎設施創新。
摩根大通稱,這種持續創新能力,預計將使輝達在未來幾年內保持GPU領域的領先優勢,並在與ASIC競爭中佔據主導地位。
一手掌握經濟脈動 點我訂閱自由財經Youtube頻道
免費訂閱《自由體育》電子報熱門賽事、球星動態不漏接
不用抽 不用搶 現在用APP看新聞 保證天天中獎 點我下載APP 按我看活動辦法





